完全自動産業用WLI-AFMシステム
Park NX-Hybrid WLIは、半導体デバイスの研究開発/生産現場における計測、品質保証、前工程のプロセスコントロール、後工程の高度なパッケージ管理などのための白色光干渉計を内蔵した世界初のAFMシステムです。サブナノの分解能と超高精度でナノスケールの領域までズームインでき、非常に広い範囲でのハイスループット計測が可能です。

-
Park NX-Hybrid WLI is the first ever AFM system
with built in White Light Interferometer
profilometry for R&D metrology, process control,
and manufacturing quality assurance of semiconductor devices. -
Park NX-Hybrid WLI provides high throughput
imaging over a very large area with the WLI
module, and nanoscale metrology with
sub-angstrom height resolution over the areas of
interest using AFM. -
Park NX-Hybrid WLI offers the ultimate solution,
ranging from large area scanning to nanoscale
metrology, for various applications including
quality assurance, automatic defect review,
front-end semiconductor process control,
and back-end advanced packaging. -
Park NX-Hybrid WLI seamlessly integrates an
automated industrial AFM system and a WLI
profilometer, bringing significant cost savings,
reduced tool footprint, and new metrology
solutions compared to the previous two tool solution.
半導体計測に最適な2つの技術を融合
- 白色干渉計(WLI):白色光干渉法は、広範囲を高速で測定できる光学技術であり、かつてないハイスループットの測定が可能です。
- 原子間力顕微鏡(AFM):原子間力顕微鏡は、走査型プローブ技術であり、透明な材料であってもナノスケールの最高の分解能で測定することができます。
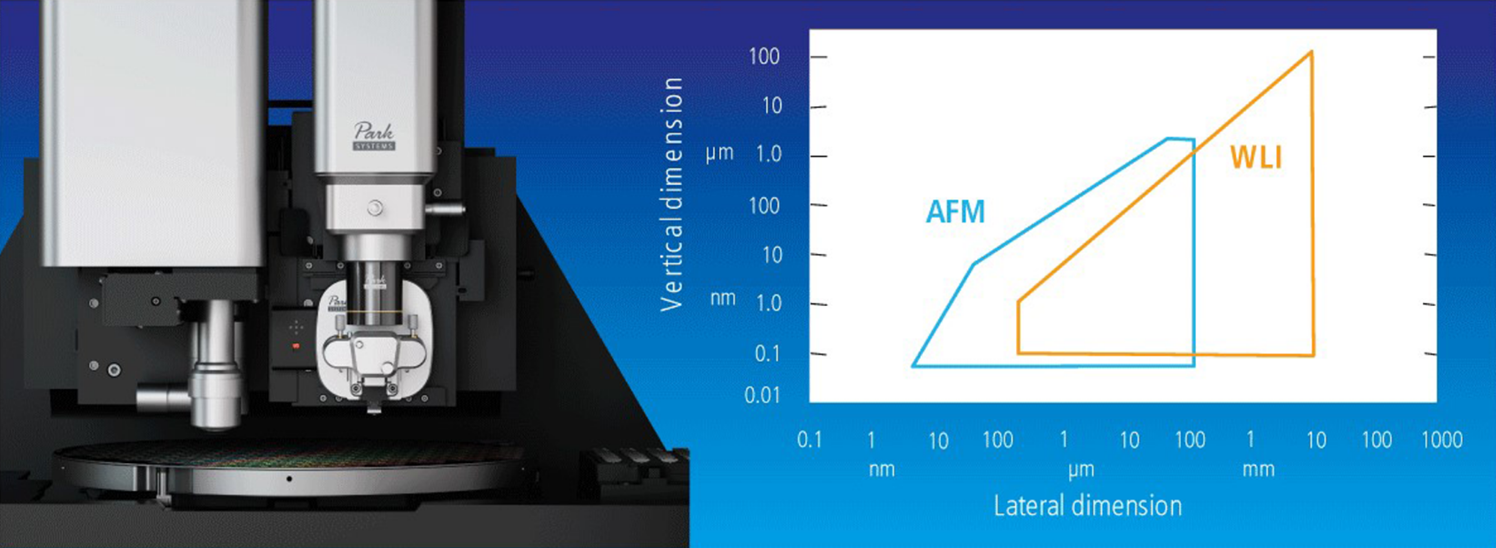
| WLI | AFM | |
|---|---|---|
| Measurement Area | Large | Small |
| Speed | High | Low |
| Lateral Resolution | Low | High |
| Vertical Resolution | High | Very High |
| Accuracy | Low | High |
WLIとAFMを組み合わせることで、視野、分解能、速度における性能が大幅に向上します。
従来のWLIの能力をはるかに超える高分解能・高精度を必要とするWLIアプリケーション
- 高度なCMP計測・モニタリング
- パッケージングの高度化
- ダイレチクル上のホットスポットおよび欠陥検出
- ウェーハレベルの計測
より広い計測範囲と高いスループットを必要とするAFMアプリケーション
- インライン・ウェーハ計測
- CMP特性評価用ロングレンジ・プロファイリング
- サブオングストローム表面粗さ制御
- ウェーハの検査および解析