Increase your
productivity with our
powerfully versatile AFM
The Park NX20 Lite includes many unique capabilities
that make it ideal for shared labs that handle a diverse range of samples, researchers
doing multi variant experiments, and failure analysis engineers working on wafers.
Its reasonable price and robust feature set also make it one of
the best value large-sample AFMs in the industry.
The Most Convenient Sample
Measurements with MultiSample
Scan
-
Automated imaging of multiple samples in one pass
-
Specially designed multi-sample chuck for the loading
of up to 16 individual samples (optionally available)
-
Fully motorized XY sample stage travels up to 150 mm x 150 mm
Accurate XY Scan by Crosstalk Elimination
-
Two independent, closed-loop XY and Z flexure scanners
-
Flat and orthogonal XY scan with low residual bow
-
More accurate height measurements enabled by NX electronic controller without any need for software processing
Best Tip Life, Resolution and Sample
Preservation by True Non-Contact™
Mode
-
Fast Z-servo speed enabling True Non-Contact™ Mode
-
Minimum tip wear for prolonged high-quality and
high-resolution imaging
Versatile Range of Modes and Options
-
Comprehensive set of measurement modes and characterizations
-
Expanded capabilities with optional accessories and upgrades
-
Advanced electrical measurements for failure analysis (FA)
The most convenient
sample measurements
with MultiSample™ scan
Park NX20 Lite MultiSample™
scan system
-
Automated imaging of multiple samples in one pass
-
Specially designed multi-sample chuck for the loading of up
to 16 individual samples
-
Fully motorized XY sample stage travels up to 150 mm x 150
mm
Using the motorized sample stage, MultiSample Scan™ enables
programmable multiple region imaging in step-and-scan
automation.
Here’s how it works :
-
Register multiple scan positions defined by a
user
-
Image from the first scan position
-
Lift a cantilever
-
Move the motorized stage to the next user defined coordinate
-
Approach
-
Repeat scan
The registration of multiple scan positions is easily
carried out by either entering sample-stage
coordinates or sample de-skewing by two
reference points. This automated feature greatly
increases productivity by reducing the need for
your interaction during the scan process.
Flat Orthogonal XY
Scanning without
Scanner Bow
Park's Crosstalk Elimination scanner structure removes scanner bow,
allowing flat orthogonal XY scanning regardless of scan location, scan rate,
and scan size. It shows no background curvature even on flattest samples,
such as an optical flat, and with various scan offsets.
This provides you with a very accurate height measurement and precision nanometrology
for the most challenging problems in research and engineering.
Decoupled XY and Z Scanners
The fundamental difference between Park and its closest competitor
is in the scanner architecture. Park’s unique flexure based
independent XY scanner and Z scanner design allows unmatched data accuracy
in nano resolution further improved with
NX AFM Head (Z scanner) powered by NX AFM electronic controller.
Industry Leading Low Noise Z Detector
Park AFMs are equipped with the most effective low noise Z detectors
in the field, with a noise of 0.02 nm over large bandwidth. This produces highly accurate
sample topography and no edge overshoot. Just one of the many ways
Park NX series saves you time and gives you better data.
Accurate Sample Topography Measured by Low Noise Z Detector
Accurate Sample Topography Measured by Low Noise Z Detector
-
Uses low noise Z detector signal for topography
-
NX electronic controller provides low Z detector noise of 0.02 nm over large bandwidth
-
Has no edge overshoot at the leading and trailing edges
-
Needs calibration done only once at the factory
Sample: 1.2 μm Nominal Step Height
(9 μm x 1 μm, 2048 pixels x 128 lines)
Better tip life,
sample preservation,
and accuracy with
True Non-Contact™ Mode
True Non-Contact™ Mode is a scan mode unique to Park AFM systems
that produces high resolution and accurate data by preventing destructive tip-sample interaction during a scan.
Unlike in contact mode, where the tip contacts the sample continuously
during a scan, or in tapping mode, where the tip touches the sample periodically,
a tip used in non-contact mode does not touch the sample. Because of this,
use of non-contact mode has several key advantages. Scanning at
the highest resolution throughout imaging is now possible as the tip’s sharpness is
maintained. Non-contact mode avoids damaging soft samples as the tip and sample surface avoid direct contact.
Accurate Feedback by Faster Z-servo enables True Non-Contact AFM
-
-
Non-destructive tip-sample interaction → Minimized sample modification
-
Maintains non-contact scan over a wide range of samples and conditions
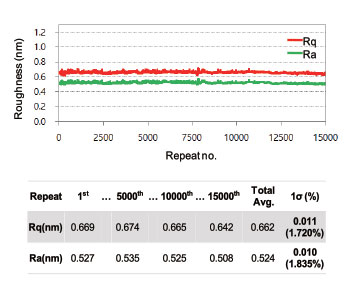
Furthermore, non-contact mode senses tip-sample interactions occurring all around the tip.
Forces occurring laterally to tip approach to the sample are detected. Therefore, tips used in non-contact mode can avoid crashing into tall structures
that may suddenly appear on a sample surface. Contact and tapping modes only detect the force coming from below the tip and are vulnerable to such crashes.
Park AFM Modes
Park Advanced AFM Modes
Park AFMs feature a comprehensive range of scanning modes so you
can collect a wide array of data types accurately and
efficiently. From the world’s only True Non-Contact™ Mode that
preserves tip sharpness and sample integrity to advanced
Magnetic Force Microscopy, Park offers the most innovative,
accurate modes in the AFM industry.